-
Электронная почта
kemei@cschem.com.cn
-
Телефон
0731-82222145
-
Адрес
Yuelu District, Changsha Yuelu Road, 28, 5 - й шахтный научно - технический парк C4, 3 - й этаж
Чанша Кэмэй аналитическая компания с ограниченной ответственностью
Японский электронный микроскоп с коррекцией сферической аберрации HD - 2700
- Модель
- Природа производителя
- Производители
- Категория продукта
- Место происхождения
Японский электронный микроскоп с коррекцией сферической аберрации HD - 2700
Презентация продукции:
HD - 2700 представляет собой полевую лучевую линзу с коррекцией сферической аберрации 200 кВ. По сравнению с обычными линзами HD - 2700 использует технологию коррекции сферической аберрации, которая значительно уменьшает влияние аберрации линзы на разрешение, что позволяет осуществлять наблюдение с очень высоким разрешением. В то же время HD - 2700 в настоящее время является одним из немногих линз, в которых доминируют функции сканирующей линзы (STEM). Технология запуска электронных пушек и коррекции сферической аберрации с функциональным полем STEM под общим углом фокусировки позволяет HD - 2700 получать электронный луч субнанометрового уровня, что делает возможным наблюдение изображений и анализ элементов с атомным разрешением и значительно улучшает возможности наблюдения и анализа зеркал.
Основные характеристики японского электронного микроскопа HD - 2700 с коррекцией сферической аберрации:
наблюдение с высоким разрешением
Использование частиц золота обеспечивает изображение DF - STEM с разрешением 0.144nm (стандартный тип).
Анализ больших пучков
Приблизительно в 10 раз больше, чем ток некорректированного зонда STEM, который позволяет проводить высокоскоростной и высокочувствительный спектральный анализ и получать карты распределения поверхности элементов за более короткое время, что позволяет обнаруживать микроэлементы.
Упрощенные операции
Предоставляет GUI - автоматический корректор сферической разницы
Целостное решение
Стержни образцов совместимы с Hitachi FIB и обеспечивают комплексное решение в наномасштабе, от получения образцов до получения данных и конечного анализа zui
Множество аналитических и аналитических функций можно выбрать
Возможность одновременного получения и отображения изображений SE & BF, SE & DF, BF & DF, DF / EDX и DF / EELS; Может быть оснащена системой Mapping элементов реального времени ELV - 2000 (изображения DF - STEM могут быть получены одновременно); Можно одновременно наблюдать изображения DF - STEM и дифракционные изображения; Может быть оснащен сверхмикроцилиндрическим стержнем для трехмерного анализа (вращение на 360 градусов) и так далее.
Технические параметры:
| проект | Основные параметры |
| Электронная пушка | Электронные пушки с холодным или тепловым полем |
| напряжение ускорения | 200 кВ, 120 кВ* |
| 0.144nm (стандартный тип, с разностью сфер, холодным или тепловым полем) | |
| Разрешение линии | 0.136nm (тип с высоким разрешением, с разностью шаров, холодным полем) |
| 0.204nm (стандартный тип, с тепловым полем, без разности сфер) | |
| увеличение | 200 х - 10 000 000 х |
| Режим изображения | Образ контрастности BF - STEM (изображение TE), изображение футеровки атомного номера DF - STEM (изображение ZC), вторичное электронное изображение (изображение SE), электронное дифракционное изображение (необязательно), характерное рентгеновское изображение (необязательно: EDX), изображение EELS (необязательно: ELV - 2000) |
| Электронная оптика | Электронная пушка: электронная пушка с холодным или тепловым полем, встроенный анодный нагреватель |
| Линзовая система: двухступенчатый конденсатор, объектив, проекция | |
| Шаровой корректор: шестиполюсный / передающий двойник (стандартный тип и тип с высоким разрешением) | |
| Сканирующая катушка: двухступенчатая электромагнитная катушка | |
| Смещение потенциала: ±1 мкм | |
| Стержень образца | Боковая вставка, X = Y = ±1 мм, Z = ± 0,4 мм, T = ± 30 ° (стержень с одним наклоном) |
Область применения:
HD - 2700, как сканирующее линзирование с коррекцией сферической аберрации полевой эмиссии, обладает не только способностью наблюдать изображения с высоким разрешением, но и аналитической способностью с высоким пространственным разрешением, что позволяет анализировать элементы атомного класса в сочетании с EELS и EDS. HD - 2700 имеет несколько режимов визуализации, которые могут удовлетворить потребности большинства образцов в наблюдении, а режим SE - визуализации Hitachi * позволяет получать информацию о поверхности образца, которую линза не может получить, и в то же время имеет более высокое разрешение, чем обычное сканирующее зеркало, которое позволяет наблюдать поверхность образца с высоким разрешением.

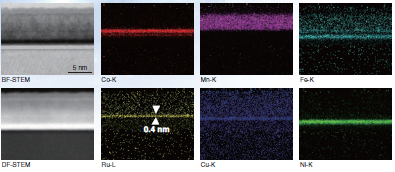
Применение статьи:
[1] Ciston1, J., Brown2, H. G., D`Alfonso2, A. J., Koirala3, P., Ophus1, C., Lin3, Y., Suzuki4, Y., Inada5, H., Zhu6, Y. & Marks3, L. D. Определение поверхности посредством атомно разрешенного вторичного электронного изображения. Nature Communications, 2005, 6, 7358-7365.
Zhu1*, Y., Inada2, H., Nakamura2, K. & Wall1, J. Изображение отдельных атомов с использованием вторичных электронов с помощью электронного микроскопа с коррекцией аберрации. Материалы природы, 2009,8, 808-812.